發布時間:2025-12-17 14:38:38 責任編輯:漢思新材料閱讀:67
圍壩填充膠(Dam & Fill,也稱 Dam-and-Fill 或圍堰填充)工藝是芯片封裝中一種常見的底部填充(Underfill)或局部保護技術,主要用于對芯片、焊點或敏感區域提供機械支撐、熱應力緩沖以及環境防護(如防潮、防塵、抗化學腐蝕等)。該工藝特別適用于需要局部加固但又不能整體灌封的場合,比如CSP(Chip Scale Package)、BGA(Ball Grid Array)、Flip Chip(倒裝芯片)等先進封裝形式。
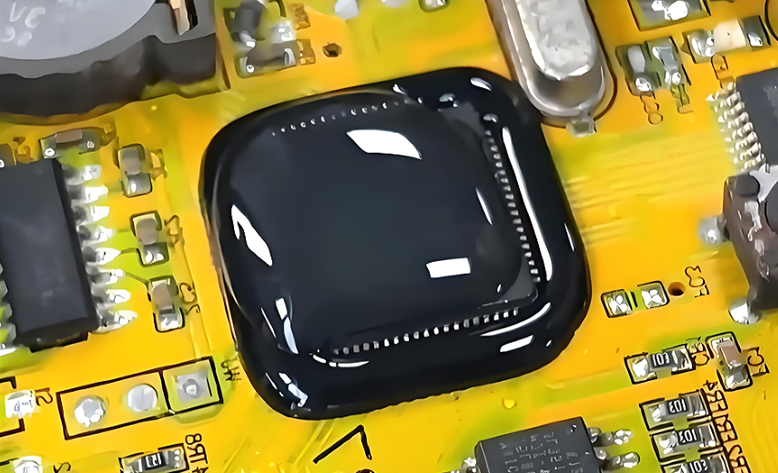
一、圍壩填充膠工藝的基本原理
圍壩填充膠工藝分為兩個主要步驟:
圍壩(Dam):
使用高粘度、快固化的膠水(通常為環氧樹脂類)在芯片周圍或特定區域涂布一圈“圍壩”,形成一道物理屏障。這道圍壩的作用是:防止后續填充膠溢出到不需要保護的區域;控制填充膠的流動范圍;提供一定的結構支撐。
填充(Fill):
在圍壩形成的封閉區域內注入低粘度、流動性好的填充膠(通常是毛細作用型底部填充膠),使其通過毛細作用滲入芯片與基板之間的間隙,包裹焊球/凸點,固化后形成牢固連接。
二、具體應用場景
Flip Chip 封裝:
倒裝芯片的焊點非常微小且密集,容易因熱膨脹系數(CTE)不匹配產生應力開裂。圍壩填充可有效緩解熱機械應力,提升可靠性。
高可靠性電子產品:
如汽車電子、航空航天、工業控制等領域,對封裝可靠性要求極高,圍壩填充可增強抗振動、抗沖擊能力。
異質集成與2.5D/3D封裝:
在多芯片堆疊或硅中介層(Interposer)結構中,圍壩填充可用于局部區域加固,避免全局灌封影響散熱或信號完整性。
維修與返工:
對已失效的BGA器件進行返修后,可通過圍壩填充增強其機械強度和長期可靠性。
三、工藝流程簡述
表面清潔與預處理:確保基板和芯片表面無污染,提高膠粘附力。
點膠形成圍壩:使用精密點膠設備(如噴射閥、螺桿泵)沿芯片邊緣施加圍壩膠。
圍壩膠初步固化(可選):部分工藝會先進行UV或熱預固化,以穩定圍壩形狀。
注入填充膠:在圍壩內注入低粘度填充膠,依靠毛細作用或壓力輔助填充間隙。
整體固化:通過熱固化或UV+熱雙重固化方式使膠體完全交聯硬化。
檢測與返修:通過AOI、X-ray或超聲掃描檢查填充是否完整、有無氣泡或空洞。
四、材料選擇要點
圍壩膠:高粘度(>10,000 cP)、觸變性好、快速定位、低收縮率。
填充膠:低粘度(<500 cP)、良好流動性、低吸濕性、匹配CTE、高玻璃化轉變溫度(Tg)。
兩者需具備良好的兼容性,避免界面分層。
五、優勢與挑戰
優勢:
精準控制膠體分布,節省材料;
提升封裝可靠性,延長產品壽命;
適用于復雜布局和高密度互連。
挑戰:
工藝窗口窄,對點膠精度要求高;
圍壩高度與寬度需優化,否則影響填充效果;
氣泡、空洞、膠體溢出等缺陷風險較高;
固化過程中的應力管理需謹慎。
總結
圍壩填充膠工藝是一種兼顧可靠性與工藝靈活性的先進封裝保護技術,通過“先圍后填”的策略,在關鍵區域實現精準加固與密封。隨著先進封裝向更小間距、更高集成度發展,該工藝在高端電子制造中的應用將持續擴大。
文章來源:漢思新材料
請填寫您的需求,我們將盡快聯系您